TIP41C低频大功率平面晶体管芯片设计
0 引言
TIP
事实上,TIP
1 TIP
TIP
PC:集电极功率耗散(Tc=
BVCEO:集电极-发射极电压为100 V
BVEBO:发射极-基极电压为5 V
IC:集电极电流为
TlP

2 TIP
对于以上设计要求,可通过理论计算来确定TIP
2.1 集电结的结深和外延层电阻率的确定
若选取集电结结深xjc等于8μm,那么,根据BVCEO≥100 V,且,则有: 。考虑到余量的充分性,可取BVCEO等于280 V为设计目标。假设基区表面杂质浓度(硼扩)NSB为
2.2 基区宽度Wb和发射结结深xje的确定
低频大功率晶体管的Wb、xje主要根据击穿电压和安全工作的需要来选定。图1是集电结附近的杂质分布和势垒情况,其中x1和x2分别是集电结在基区部分和集电区部分的势垒宽度,它们的总势垒宽度是δ=x1+x2。这样,在NC为2×

为了保证击穿电压的要求,应尽可能的提高二次击穿耐压量,晶体管的基区宽度应大于2.45μm,但又不能太大,否则基区输运系数η会减小。从而使电流放大系数减小,因此应选择基区宽度Wb=3μm。由于集电结结深xjc=Wb+xje=8μm,因此,一般来说,发射结xje应等于基区宽度的 1.0~2.5倍。综合以上考虑,可确定基区宽度Wb为3μm,发射结结深xje为5μm。
2.3 外延层厚度T的确定
外延层厚度T至少应等于集电区厚度WC、集电结结深xje、反扩散层三部分之和。为了能达到BVCBO指标,集电区高阻层厚度WC应大于为集电结雪崩击穿时对应的空间电荷宽度XmB。
从改善雪崩注入二次击穿的角度考虑,希望集电区厚度WC≥BVCBO/EM,其中EM为最大电场强度。
南于TIP
2.4 基区硼扩散浓度的确定

2.5 发射区磷扩散浓度的确定
为了保证有足够的放大系数,要求发射区的磷扩散表面浓度约为
3 TIP
TIP

N型外延片→一次氧化→一次光刻→干氧氧化→B离子注入→深基区扩散→二次光刻→磷预淀积→发射区扩散→特性光刻→特性hFE测试→P吸杂(PSG) →PLTO(低温氧化)→H2处理→三次光刻→QC检测(hFE、BVCBO、BVCEO)→蒸铝→四次光刻→铝合金→QC检测VBESAT→五次光刻 →PI胶钝化→中测抽检电参数→背面减薄(220μm)→蒸银→中测测试电参数→入库
图2所示是TIP
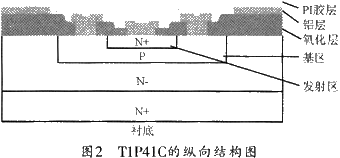
由于作者所在单位的生产车间设计比较简单,车间环境净化程度不高,因此,在一次氧化、基区扩散工艺中采用TCA工艺来对一次氧化、二次氧化过程中Na +的污染进行有效控制,发射区扩散采用P-吸杂工艺来控制三次氧化过程中Na+的产生,表面钝化则采用PI胶工艺来保证外界环境不影响芯片表面,同时进一步吸收、稳定氧化层正电中心的移动,从而使芯片ICEO漏电大大减少,目前,TIP
4 结束语
大量生产数据表明,我司设计的TIP