MEMS:芯片外的封装级设计考虑


传统ME图5 高密度耳蜗植入系统使用一个石英硅帕拉胶封装工艺,它可以提供良好的生物兼容性、灵活性和长期使用的稳固性。
MS器件封装形式
早期MEMS器件封装形式采用SOC(System-on-Chip:片上系统)技术、以CMOS工艺组装一个或多个MEMS器件,包括模拟和数字工艺。MEMS产品也可以采用SIP(System-in-Package:封装内系统)技术在前面讨论的封装中集成两个或多个芯片。搭接线(wire-bonding)用于连接封装内的芯片,包括MEMS芯片。现今,这种技术正被集成电路生产领域中的倒装芯片封装技术所替代(见图6)。
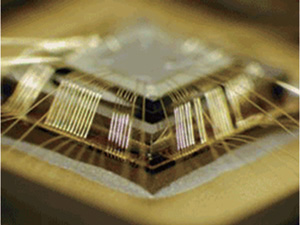
图6 在电信光交换器件(底层管芯)和CMOS控制电路(顶层管芯)的堆叠连接
在以前,工程师常常把封装设计留在关键传感器和电路设计完成后的最后阶段。然而,这种设计流程在产品面市压力和激烈竞争的冲击下发生了变化,迫使工程师改变他们的设计方法。否则,产品封装的劣势将会错过极佳市场窗口。另外,由于设计工具匮乏,当应力或其他影响因素没有被合理评估时,就使得设计失败。
新型开发工具
当前,用于封装设计的新技术已经接近了MEMS器件制造的水平。硅通孔(TSV)蚀刻技术可以实现高达100多μm的晶圆蚀刻深度。因此,MEMS晶圆厂就可以采用这种和MEMS制造相同级别的技术来制造封装了。
硅通孔(TSV)的运用使另外一种技术得以实现,那就是多芯片堆叠技术。该技术将多个芯片的管芯堆叠在一个封装中,并通过硅通孔连接在一起。芯片堆叠使芯片的封装更小,但会使封装会变得更加复杂。热量必须在堆叠得极其接近的芯片之间传递,从而产生散热问题;另外机械结构的稳定性也必须仔细仿真以确保良好的性能和可靠性。传统的集成电路封装工厂目前也开始提供特殊的MEMS器件封装,而且设备供应商也投入开发新的封装和测试设备。因此,MEMS器件的封装选择是很多的。MEMS器件集成多个传感器,以及与相应的软件配套来提供更高附加值的系统正逐渐向多芯片封装解决方案方向发展。芯片堆叠可以通过一次一片的方式生产,也可以通过晶圆级封装方式进行。
未来发展趋势
封装技术中的一个重要新方向是使用柔性衬底把多个刚性器件封装在一起。多个传感器可以和电子单元及功率模块组合在一起。通过折叠,被封装在一起的系统尺寸可以做得非常小。这种技术对于可穿戴人体传感器非常有吸引力。
当集成电路领域的封装供应商关注其他附加值时,封装的标准化就有可能了,但这需要很长的时间。在什么地点,由谁来起草这个标准也需要大量的时间。这是因为MEMS和半导体晶圆厂与传统封装厂之间的竞争将使最新和最高性能的封装技术得以开发,也使得更多的传统半导体晶圆厂开始为MEMS业界提供服务。