浅谈3D芯片堆叠技术现状
3DIC行规制定现状:
不过TSV技术面临的主要问题之一是缺乏业内标准。去年12月份,SEMI联盟组织开始在这方面有所行动,他们成立了一个三维堆叠集成电路标准委员会(Three-Dimensional Stacked Integrated Circuits (3DS-IC) Standards Committee)。
为了广泛获取业界的支持,并确定需要进行标准化的项目。SEMI组织正与Sematch展开合作,合作的内容是确定未来一段时间内3D芯片堆叠技术的应用方向。Sematech组织的成员众多,包括Globalfoundries, 惠普, IBM, Intel, 三星以及联电等,其它支持该3DS-IC标准项目的公司还有Amkor, ASE, IMEC, ITRI, Olympus, 高通, Semilab, 东电电子以及赛灵思.
该三维堆叠集成电路标准委员会成立的初期将包含三个工作组:
1-晶圆对键合(Bonded Wafer Pair (BWP) )工作组:这个工作组的任务是为BMP有关的技术订立标准,工作组将以刚刚成文的SEMI M1标准(代号M1的标准的主要内容是为抛光处理后单晶硅晶圆片的尺寸,物理性能以及量测方法进行新的规定,以便为TSV技术打下基础)为起点开展工作,该工作组的领军人将是Sematech联盟;
2-量检验工作组:顾名思义,该工作组的目标是为3DS-IC项目制定必要的量测技术标准,这个工作组由Semilab牵头负责;
3-薄化载体晶圆工作组:载体晶圆的作用是作为3D堆叠芯片的衬底,工作组的目标是为薄化载体晶圆制定适于3DS-IC使用的新标准,该工作组由高通领衔。
除此之外,还有另外一个工作组也已经在组建的过程中,该工作组将专注于“堆叠制程用单片晶圆技术”,该工作组将由应用材料公司领衔。
SEMI组织还透露本周早些时候3DS-IC标准委员会召开了一次会议,会议的主题是开始为3DS-IC用晶圆片制订晶圆片参数等标准,有关的标准草案则将于明年早些时候出炉。
另外,去年Sematech组织还宣布建成了首个
据Sematech高管Sitaram Arkalgud透露,该产线设立的主要目的是为Wide I/O产品研发出一套“参考工艺流程”,所用的TSV结构宽度为5微米,深度则为500微米。
席卷全球的3DIC热潮:
另外一方面,去年由Sematech,SIA(Semiconductor Industry Association)以及SRC(Semiconductor Research Corp.)三大组织牵头,启动了另外一项与3D芯片堆叠技术有关的研究项目,该项目的目标主要是为可应用于多种场合的异质结构3D芯片互联技术制定行业标准规范。目前加入这个项目的成员有ADI, Altera, LSI, 安森美和高通。
对3D芯片堆叠而言,晶圆键合技术所起到的作用非常关键。根据国际半导体技术路线图(ITRS)的预计,2012年后应用的TSV穿硅互联结构中的微过孔直径将被控制在0.8-4.0微米之间。
美国Sematech组织在欧洲的对手IMEC也在积极研制与3D芯片堆叠有关的技术。本月早些时候,Cascade Microtech公司和IMEC宣布将就3DIC的测试方法研制项目进行合作。两家公司将在3D TSV技术所用的量测方法方面展开紧密合作,并宣称将在3DIC用研发及产品测试标准制定领域走在全球前列。
另外,法国的CEA-Leti也已经开始启动基于
亚洲方面,新加坡微电子所( Institute of Microelectronics (IME))最近也组建了一个与3D堆叠技术有关的联盟组织,台湾工研院(ITRI)也组建了一个类似的联盟组织,其成员数达到了22家公司,包括联电,思科,日月光等。
去年,尔必达,力成科技及联电三家公司还宣布将合作开展基于28nm节点制程的3D芯片堆叠技术的研发。
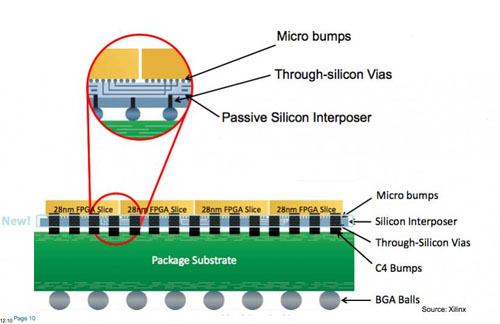
赛灵思的FPGA 3D堆叠技术
最后,赛灵思则在去年宣布推出可将多块FPGA核心通过3D堆叠技术集成在单片封装中的技术,并将把这种技术应用在其28nm制程7系列FPGA产品上。有关的产品定于今年下半年上市。
另:
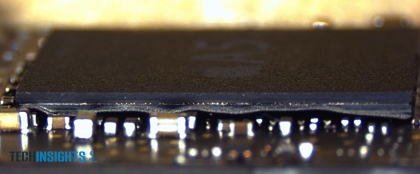
A5芯片侧面肉眼可见上下层芯片的分界结构
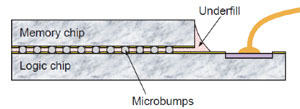
苹果A4/A5处理器虽然也使用了类似3D芯片堆叠的技术,但并没有使用TSV和Interposer结构,而是采用如上图所示的结构,直接通过Microbump实现内存芯片与逻辑芯片的互联。